译自原文
Milliwatt-power sub-230-nm AlGaN LEDs with >1500 h lifetime on a single-crystal AlN substrate with many quantum wells for effective carrier injection
原文作者
Hirotsugu Kobayashi, Kosuke Sato, Yusuke Okuaki, TaeGi Lee; Tomohiro Morishita; Hiromasa Goto; Naohiro Kuze
原文链接
https://doi.org/10.1063/5.0139970
项目支持方
日本旭化成研发部先进器件技术中心紫外光电项目
摘要
我们在AlN单晶衬底上制备出了低于 230 nm(Far-UVC)发光二极管(LED)。利用 20 个量子阱周期来增强有源层中的载流子注入,在 100 毫安工作电流下获得了超过 1-mW的输出功率(226 nm和 229 nm发光二极管的输出功率分别为 1.4 和 3.1 mW)。单芯片 229 nm LED 在 700 毫安工作电流下的最大输出功率达到 21.1 mW,且无明显衰减。在 100 mA 下工作的两个亚 230 nm LED正向电压都很低(5.9 V),这是因为它们的电阻很低,而且金属和半导体元件之间有理想的欧姆接触。此外,226 nm和 229 nm LED 的WPE效率分别为 0.24% 和 0.53%。226 nm LED 在 25 ℃ 温度下工作时的寿命超过 1500 小时,即使在 1524 小时后也没有出现电流泄漏。要实现如此长的使用寿命,需要通过大量量子阱来改善载流子注入,使用高质量的AlN衬底,并实现较高的WPE效率。
AlGaN基UVC-LED已被广泛开发为消毒或化学分析的光源。作为一种相对较新的应用,Far-UVC(200-240nm)被重点用于灭菌而不会对动物皮肤或眼睛造成重大伤害,因此AlGaN基Far UVC-LED已被广泛研究并成为热点。与常用的可见光或UV-LED(260~nm)相比,Far UVC-LED输出功率低、工作电压高、寿命短,因此仍不实用。UV-C LED 的外部量子效率(EQE)在发射波长较短时急剧下降,尤其是那些短于 230 nm 的波长。造成这种下降的原因包括:点缺陷的增加,如易在富铝AlGaN中形成的阳离子空位;量子阱(QW)内载流子约束不良导致的电流溢出;以及TM-mode发射模式占主导地位导致的光提取不良。
对较短的发射波长需较高的工作电压是由于高铝组分n-AlGaN和p-AlGaN较高电阻率以及金属与AlGaN之间的接触电阻率增加所致。富铝的n-AlGaN或p-AlGaN中载流子浓度的降低是由于硅和镁掺杂剂的活化能非常高。这不仅会增加AlGaN薄膜的电阻,还会在金属和AlGaN之间产生肖特基接触。延长这些LED的使用寿命也是一项挑战。很少有研究报道发光波长在 230 nm到 240 nm之间 LED 的使用寿命,也几乎没有波长低于 230 nm的 LED 使用寿命报道。所有关于UVC-LED 的报告都显示,在最初的 100 小时内,输出功率的衰减幅度大于 50%,因此使用寿命较短。Glaab 等人认为,光功率的降低与热载流子促进的奥杰尔复合有关;Pinos 等人解释说,电流应力期间发射功率的降低与氮空位的增加有关。然而,降解的详细机制仍不清楚,尤其是对于 230 nm以下的 LED。因此,提高输出功率、降低工作电压和延长使用寿命是 230 nm以下 LED 实际应用中急需实现的目标。
AlGaN外延层是在 C面单晶AlN衬底上生长的。根据 AlN 衬底的 X 射线衍射摇摆曲线 (XRC) 光谱计算得出的002/104半峰宽(FWHM)分别为 6.7 和 7.8 arcsec。AlN单晶衬底的穿线位错密度(TDDs)是通过计数 X 射线形貌图中显示的数量来确定,估计小于 1 x 105 cm-2,根据透射率计算出的AlN衬底230 nm波长吸收系数在15-25 cm-1 之间。
所有样品均采用MOCVD工艺制备。AlGaN薄膜的生长温度为 1050°C 至 1080°C,气源 V/III 摩尔比为 4000。气源包括三甲基铝(TMA)、三甲基镓(TMG)、三乙基镓(TEG)、NH3、SiH4 和双环戊二烯基镁(Cp2Mg)。在AlN单晶衬底上生长出掺Si的 Al0.87Ga0.13N 电流扩散层后,又生长出 20 周期的量子阱(20QW,有源层),其中包括 3 nm厚的 Al0.85Ga0.15N阱层和 6 nm厚的 Al0.92Ga0.08N 阻挡层,可用来发出 226 nm的光。通过改变 AlGaN 阱层和 AlGaN 势垒层的 Al/(Al+Ga)比率,同时保持它们之间 Al/(Al+Ga)比率的差异,设计并制备出了其他亚 230 nm LED。在 20QWs 中,首先生长了一个 AlN 电子阻挡层以阻挡电子溢出到 p 型层,然后依次成功生长出一个 Al 成分渐变的 AlGaN 层和一个 p-GaN 接触层。
从 226 nm和 229 nm LED获得的 X 射线倒空间映射成像图来看,所有AlGaN层都是在AlN衬底上相干生长的。n-AlGaN 的(002)和(104)HRXRD分别为 68 和 88 arcsec,很显然表明晶体质量很高。通过二次离子质谱分析,n-AlGaN 中的Si浓度为 1x1019 cm-3,所有 AlGaN 层中的C和O杂质浓度均低于 1x1017 cm-3 的检测限。在进行基于 Cl2 的干法蚀刻以暴露 AlGaN的n极性面后,沉积了一个由 Ti/Al/Ni/Au 组成的 n 型电极(20/150/30/50 nm),并在 870℃下退火。然后,在 p-GaN 上沉积镍/金(20/35 nm)p 型电极,并在 600 ℃ 下退火。在 n 型电极和 p 型电极上都沉积了额外的垫层(pad)金属,以实现有效的电流扩散。金属沉积后,AlN 衬底被减至 100 μm厚度,以抑制衬底的光吸收,然后对衬底背面进行粗化处理,以有效提取TM-mode发射光,这通常在Far UVC- LED 中占主导地位。然后,将1.8 x 1.8 mm2的正方形 LED 芯片翻转,并使用金-金互连技术将其粘合到AlN基封装上,而无需额外封装或密封。在 100mA 电流下,将电流除以 LED 芯片的有效面积计算得出的平均电流密度为 4.3 A/cm2。使用光谱仪和积分球测量了Far UVC- LED在10 ms脉冲操作下的输出功率。寿命评估是在恒温烤箱中进行的,设置为25℃,封装的LED连接到Al基板上,与没有任何空气或水冷却系统的散热器接触。
为了估算 20QW 内的载流子复合机制,使用 SiLENSe 6.4 版(日本 STR 公司)对 226 nm LED 进行了波段模拟。该模拟是沿 AlGaN 薄膜垂直轴的一维模拟,不考虑 n-AlGaN 中的水平电流扩散、n型金属和 n-AlGaN 之间的接触电阻以及 p型和 p-GaN 之间的接触电阻。图 1(a) 显示了 5QW 在电流密度为 4.3 A/cm2 时的电子(蓝色)和空穴(红色)浓度分布。所有阱中的电子浓度都很高(>1018 cm-3),但空穴浓度却很低(1013 -1017 cm-3),导致 CIE 低至 2.2%,远低于传统 265 nm发射紫外UV-C LED 的 CIE(>40%)。这种低 CIE 可归因于阱内载流子封闭性较差,p-金属侧 3.0 A/cm2 的高电子泄漏电流和 n-金属侧 0.9 A/cm2 的空穴泄漏电流就说明了这一点。
增加 QW 内载流子束缚的传统方法是设计更厚的阱或增加AlGaN阻挡层的铝含量。然而,厚阱不利于Far UVC-LED,原因有二。首先,由于大内电场导致量子限制斯塔克效应(QCSE),电子和空穴波函数重叠减少。由于内部量子效率 (IQE) 取决于辐射和非辐射复合寿命之间的平衡,因此在具有更多非辐射复合中心的富铝AlGaN阱层中,QCSE 的影响会变得更加严重。其次,不利 TM 发射的比例会增加,从而降低光提取效率。增加势垒高度的方法也是不够的,因为势垒的Al/(Al+Ga)比已经达到 0.92,这几乎是 AlGaN 的上限。因此,为了提高 CIE,本研究将 QW 周期增加到了 20。图 1(b) 显示了 20QW 的电子(蓝色)和空穴(红色)浓度的计算分布。20 个周期 QW 每个阱中的空穴浓度与 5 个周期的 QW 几乎相同。然而,随着 QW 数量的增加,空穴注入总量也随之增加,20QW 的 CIE 值是 5QW 的 5 倍,因为在几乎相同的电子漏电流下,空穴漏电流从 0.9 A/cm2 减少到 0.4 A/cm2 。这一模拟结果说明,对于Far UVC-LED 而言,抑制空穴漏电流对 CIE 是有效的。对于 IQE,当增加 QW 数量时,电子和空穴的重叠波函数没有变化。此外,在 4.3 A/cm2 的条件下,5 个和 20 个 周期QW 的工作电压差仅为 0.001 V,与 Al0.85Ga0.15N 的理论带隙能 5.5 eV 相比可以忽略不计。
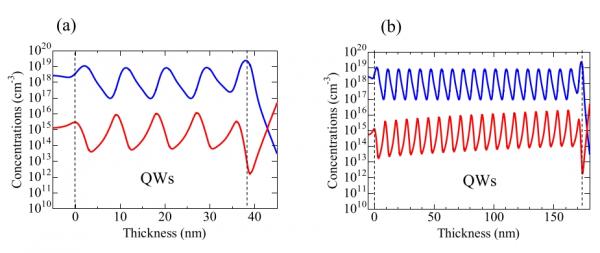
图 1. 具有 (a) 5 个量子阱和 (b) 20 个量子阱的 226 nm LED 的波段模拟结果。 蓝线和红线分别代表电流密度为 4.3 A/cm2 时的电子和空穴浓度。横轴是从 n-AlGaN 和 QW 之间的界面开始的长度。
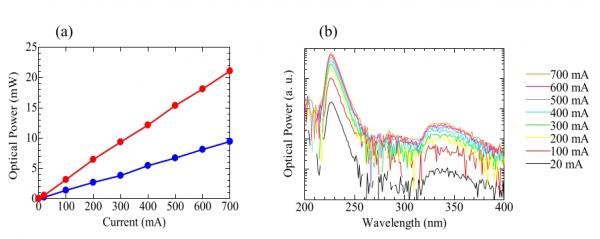
图 2. (a) 229 nm(红色)和 226 nm(蓝色)LED在不同电流下的光功率。(b) 226 nm LED 在 20 至 700 mA 电流范围内的电致发光光谱
图 2(a)和 2(b)显示了输出功率与工作电流的关系以及所制备 LED 的发射光谱。图 3 只显示了 226 nm LED 的 IV 曲线,因为与 229 nm LED 的 IV 曲线几乎相同。226 nm和 229 nm LED 的光功率随着工作电流(从 20 mA 到 700 mA)的增加几乎呈线性增长。此外,使用蓝宝石衬底的 LED 没有出现通常报告的临界衰减。图中明显的微小下垂是由于AlN单晶衬底上的 LED 薄膜具有较高的晶体质量,这与之前报道的在AlN衬底上生长的 265 nm LED 的情况相同。当工作电流为 100 mA 时,226 nm和 229 nm LED 的输出功率分别达到 1.4 mW 和 3.1 mW,对应的 EQE 分别为 0.26% 和 0.57%。单芯片 226 nm和 229 nm LED 的最大输出功率分别达到 9.4 mW 和 21.1 mW。由于使用 20QW 获得了高 CIE 和使用AlN 单晶衬底获得了高 IQE,因此这些 EQE 远高于之前报道的 230 nm以下 LED 的 EQE(8x10-6 至 0.2%)。226 nm LED 主光谱的半峰宽(FWHM)为 8 nm,从 20 毫安工作电流到 700 毫安工作电流的峰值偏移在 1 nm以内。即使以 700 mA 电流驱动,光谱在 226 nm 处也只有一个单峰,没有任何肩峰。从 260 nm到 400 nm观察到的宽发射被抑制到比 226 nm的主峰低两个数量级。从这些结果来看,注入的载流子被适当地限制在阱中,不会出现不利的电流泄漏,也不会在陷阱(如与碳有关的缺陷)处发生意外的复合。
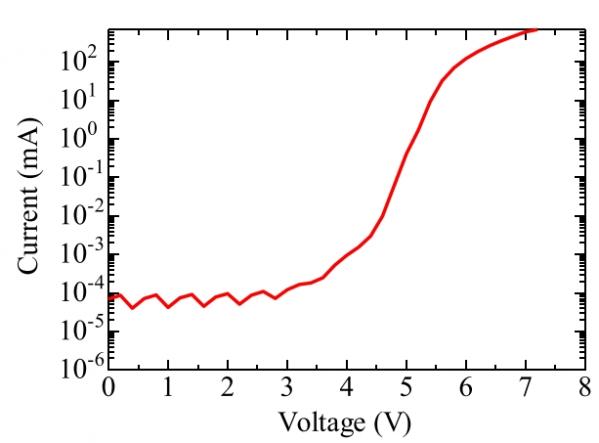
图 3. 226 nm LED 的 IV 特性。IV 特性是在 700 mA 的顺应电流下测量的。
226 nm LED 的正向电压在 100 mA 工作时为 5.9 V,在 500 mA 工作时为 6.9 V。这些值远低于之前报道的在蓝宝石衬底上使用的发射波长为 230-240 nm的Far UVC-LED 在 100 mA 下工作时的 9-20 V 电压,也低于报道的使用 p 型硅而不是 p-AlGaN 制备的 229 nm LED 的 24 V 电压。根据从 60 - 100 mA 区域的 IV 曲线估算出的校准线,226 nm LED 的阈值电压为 5.5 V,这与 Al0.85Ga0.15N 阱的理想带隙一致。亚 230 nm LED 之所以具有这些 IV 特性,是因为AlGaN的n极电阻和对AlGaN的p极电阻较低,而且电极与半导体之间的AlGaNn极电阻和对AlGaNp极电阻接触电阻也较低。根据TLM-model测量计算,n极金属与 Al0.87Ga0.13N的n极 之间的接触电阻率和 n-Al0.87Ga0.13N 电阻率分别为 5.7x 10-3 Ωcm2 和 0.061 Ωcm。这些值与之前报告的最佳值几乎相同:n-AlGaN 电阻率分别为 0.026、0.045 和 0.63 Ωcm,Al/(Al+Ga)比分别为 0.82、0.86 和 0.91,n型接触电阻率为 3.0x10-3 Ωcm2。正如已报道的那样,这些低的电阻率归因于在AlN单晶衬底上生长的高质量的AlGaN薄膜。虽然由于层内铝成分是渐变的,无法通过 TLM 方法正确测量渐变电阻率,但正如之前的研究一样,其电阻率应该很低。镍基电极与p-GaN(而不是与n-AlGaN)之间的接触电阻足够低。

图 4. 电流为 100 mA 时Far UVC-LED WPE效率。
图 4 总结了之前报道的在Far UVC 波段(220-240 nm)以 100 mA工作的 LED 的WPE效率。需要注意的是,之前几篇论文中报告的WPE效率并未提及正向电压(图 4 中未绘出)。本研究中 229nm LED 的 WPE效率为0.53%,高于之前报道的 220-240 nm LED(低于0.37%的WPE效率)。由于输出功率下降,当发射波长变短时,230 nm以下 LED 的 WPE效率会急剧下降。有研究认为,发射波长仅相差几个nm时,光功率就会迅速下降,这主要是由于 IQE 和 CIE 下降所致。为了弄清输出功率下降的原因,我们通过模拟估算了阱层中 Al/(Al+Ga)比对 EQE 的影响。通过比较 Al0.85Ga0.15N/Al0.92Ga0.18N 20QWs (λ= 226 nm)和 Al0.82Ga0.18N/Al0.89Ga0.91N 20QWs (λ= 229 nm),计算得出 226 nm LED 的 CIE 为 11.5%,几乎是 229 nm LED(23.8%)的一半。226 nm和 229 nm LED 之间测量输出功率的差异可以很好地解释它们的 CIE 差异。计算得出的 CIE 差值来自于空穴泄漏的减少,从 226 nm LED 的 0.4 A/cm2 降至 229 nm LED 的 0.1 A/cm2。与电子泄漏从 3.0 A/cm2 微降至 2.6 A/cm2 相比,空穴泄漏的抑制对 CIE 下降的影响更大。

图 5. (a) 226 nm LED 的归一化光功率与工作时间的关系。黑点和红线分别表示实验结果和拟合结果。(b) 老化样品(红线)的 IV 特性和 (c) 光谱与新鲜样品(黑线)的比较。IV 特性是在 100 mA 的限制电流下测量的,10-4 mA 以下的电流为噪声。
最后,在 25 ℃下以 100 mA电流工作时测量了226 nm LED 的使用寿命。图 5(a) 显示了与1.1 mW初始输出功率相比,工作时间与归一化光功率之间的关系。L70的使用寿命,也就是相对输出功率变为0.7的时间,达到了1500 小时以上,比之前报道的在 100 mA下工作的 230-240 nm UVC-LED 的 100 小时寿命长10倍以上。寿命长的一个可能原因是在单晶AlN衬底上生长的AlGaN层质量高,TDD 低,从而抑制了其退化。这一点可与在较低TDD的AlN/蓝宝石模板上生长的 265 nm LED进行比较讨论,通常这些较低TDD的LED表现出较慢的退化速率。高 WPE效率 还能防止 226 nm LED 产生热量和随之而来的热老化。此外,应用 20QWs 改善 CIE 对工作期间防止CIE的下降也有积极作用。为了证实 CIE 的效果,对运行 1524 小时前后的 IV 特性进行了比较,结果显示,尽管相对光功率下降到初始值的 70%,但 IV 特性保持不变 [图 5(b)]。根据参考文献中的论述,认为是 CIE 的下降是在电压低于阈值时测得的漏电流没有变化的衰减,因此 CIE 也可能是导致 226-nm LED 衰减的主要因素。此外,图 5(c) 所示的 226 nm LED 在运行 1524 小时前后的发射光谱对比也支持这一假设。226 nm 处主峰强度的下降与来自杂质或缺陷的290 nm 和 340 nm处子峰的强度相似,表明在电流应力作用下,注入阱层的载流子数量会因 CIE下降而减少。

实验结果与文献中提出的公式 (1) 相吻合。其中,t、i、α 和 β 分别代表运行时间、100 mA 时的电流以及第一和第二个拟合参数。通过采用 1x10-6 h-1 A-3 的α 和 0.053 的 β,实验曲线很好地拟合了公式 (1),这表明肖克利-雷德-霍尔(SRH)复合对光退化的影响更大。Piva 等人讨论了生长在蓝宝石衬底上的 285 nm LED 的光衰退问题,从实验数据与漏电流增加的拟合结果来看,这与中能带缺陷的产生有关。然而,生长在AlN衬底上的 226 nm LED 并未出现漏电流现象,对拟合结果的可接受解释应该是,在 4.3 A/cm2 的如此低的电流密度下,SRH 复合对退化率的影响变得很大,电流应力期间的 CIE 会下降,这一点已在参考文献的讨论中得到证实。
总之,我们在AlN单晶衬底上制备出了低于 230 nm的Far UVC-LED。在 100 mA 电流下,226 nm和 229 nm LED 的输出功率分别为 1.4 mW 和 3.1 mW,对应的 EQE 分别为 0.26% 和 0.57%。这是由于增加了 QW 数量,从而提高了有源层中的总空穴注入量。229 nm LED 的输出功率达到 21.1 mW,且无明显的电流下降。通过实现 n-AlGaN 的低电阻以及金属和n-AlGaN 之间的欧姆接触,并且在100 mA 和 500 mA 电流下工作时,正向电压分别为5.9 V和6.9 V,229 nm的 WPE 值达到 0.53%。即使经过测试,226 nm LED 的 L70的使用寿命超过了 1500 小时,且未出现电流泄漏。寿命长的原因是多量子阱改善了载流子注入,使用了具有低 TDD 的高质量AlN衬底,以及高WPE效率防止了热量的产生。
原文源于【AIP Publishing】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)