译自原文
24.4 W/mm X-Band GaN HEMTs on AlN Substrates With the LPCVD-Grown High-Breakdown-Field SiNx Layer
原文作者
JUNJI KOTANI , JUNYA YAITA, KENJI HOMMA, SHIROU OZAKI, ATSUSHI YAMADA, MASARU SATO, TOSHIHIRO OHKI, AND NORIKAZU NAKAMUR, Devices & Materials Research Center, Fujitsu Ltd.,.
原文链接
https://doi.org/10.1063/5.0174524
项目资助方
日本国防安全科技创新计划(Innovative Science and Technology Initiative for Security)和日本防卫省采办技术后勤局(ATLA)
摘要
本文报道了一种基于AlN单晶衬底的AlGaN/GaN高电子迁移率晶体管(HEMT),其在X-band实现了创纪录的高输出功率密度24.4 W/mm。通过使用高密度二维电子气沟道和再生欧姆接触,实现了1.4 A/mm的高漏极电流工作。此外,通过低压/高温化学气相沉积生长的高密度、高击穿SiNx层实现了110 V的高压运行。三级AlGaN缓冲层提高了二维电子气的电子迁移率,使我们能够生长出低碳浓度的氮化镓沟道。同时,通过采用再生的n-GaN接触层来最小化源极/漏极接触电阻,实现了1470 mA/mm的高漏极电流和258 V的高击穿电压。该研究结果表明,基于AlN单晶衬底的GaN HEMT器件在下一代高功率射频器件领域拥有巨大潜力。
引言
氮化镓(GaN)基高电子迁移率晶体管(HEMT)因其宽带隙和大击穿场强而成为高功率/高频器件极具前景的解决方案。通过使用铝镓氮化物(AlGaN)沟道的HEMTs可使击穿电压进一步改善。然而,由于合金散射,使用AlGaN沟道会导致严重的电子迁移率下降。因此,由于器件性能的改进受限于击穿电压,从而无法实现高功率的射频器件。近年来,AlN/GaN/AlN结构的研究备受关注。虽然大的信号放大已有报道,但输出功率密度限制在3W/mm。通过对生长在AlN单晶衬底基HEMT器件结构GaN沟道中的电子迁移率进行详细研究,发现通过控制AlGaN缓冲层中的极化电荷来降低GaN沟道中的内部电场可以有效地提高电子迁移率。利用极化电荷控制的AlGaN缓冲结构,我们成功地在AlN单晶衬底上实现了X-band功率密度>15 W/mm的高功率HEMT器件。然而,器件结构是采用典型的AlGaN/GaN HEMT技术实现,因此我们认为其仍有巨大提升空间。
在这项研究中,我们采用低压/高温化学气相沉积(LP/HT-CVD)的SiNx钝化层、极化电荷控制的AlGaN缓冲结构和n-GaN再生欧姆接触来提高AlN单晶衬底上AlGaN/GaN HEMT器件的最大漏极电流和击穿电压。最后,我们在AlN单晶衬底上使用AlGaN/GaN HEMT器件结构,在X-band实现了创纪录的24.4 W/mm输出功率密度。
实验
图1显示了在自支撑2英寸AlN单晶衬底上制备的AlGaN/GaN HEMT器件。采用金属-有机气相外延(MOVPE)法制备了AlGaN/GaN HEMT器件结构。为了提高电子在AlN单晶衬底上的迁移率,我们采用了三级AlGaN缓冲层:在文献所采用的缓冲结构基础上,再增加Al0.15Ga0.85N缓冲层,如图1所示。Al0.15Ga0.85N层的插入降低了GaN/Al0.15Ga0.85N缓冲层界面处的负极化电荷。这减少了GaN沟道中的内部电场,有助于提高二维电子气(2DEG)的电子迁移率。我们还注意到,三级缓冲结构有效地改善了GaN沟道的表面形貌,并使我们能够生长出碳浓度为1×16 cm−3的GaN沟道,其V/III比高达1600。在GaN沟道之后,生长了AlN间隔层、Al0.31Ga0.69N势垒层和GaN帽层。本研究使用了两种不同的SiNx钝化层:原位LP/HT-CVD和非原位等离子体增强CVD (PE-CVD) SiNx。LP/HT-CVD和PE-CVD的SiNx沉积温度分别为730℃和250℃。两种结构的SiNx层厚度均为100 nm。对于图1(a)所示的HEMT器件结构,经过LP/HT-CVD生长的SiNx钝化后,测量到的二维电子气(2DEG)密度和迁移率分别为1.3×1013 cm-2和1700 cm2/Vs。此外,采用n-GaN再生欧姆接触来减小接触电阻的影响。LP/HT-CVD SiNx的HEMT薄层电阻(Rsh)和接触电阻(Rc)分别为283Ω/sq和0.10Ωmm。通过MOVPE在715°C下进行n-GaN的再生层,采用LP/HT-CVD SiNx钝化层作为n-GaN再生过程的掩膜层。采用Ni/Au和Ti/Al金属分别作为栅极和欧姆电极,栅极长度为0.25 µm,栅极-漏极长度为3 µm。表1总结了文献中HEMT器件和本研究中HEMT器件参数。

TABLE 1. Comparison of device parameters for the HEMT in [8] and the HEMT in this study.
表1:文献报道中HEMT器件与本研究中HEMT器件参数比较。

FIGURE 1. Schematic of HEMT structures on free-standing AlN substrates (a) in this study and (b) in [8]
图1:AlN单晶衬底上的HEMT器件结构示意图:(a)本研究;(b)文献报道
结果与讨论
为了提高AlN单晶衬底上HEMTs的击穿电压,我们将重点放在栅极场板漏极侧周围的电场聚集上,因为从我们之前的模拟结果来看,严重的电场聚集发生在栅场板边缘。因此,增大SiNx层的击穿场强是必不可少的。此外,我们比较了LP/HT-CVD和PE-CVD沉积的SiNx的击穿行为,如图2所示。PE-CVD和LP/HT-CVD SiNx的击穿场强分别为3.6和6.0 MV/cm。为了研究带有再生长欧姆接触的LP/HT-CVD SiNx层的击穿行为,在氮气气氛下进行了30分钟715℃的高温退火。如图2所示,我们证实了即使经过高温退火,击穿行为也是热稳定的,这与n-GaN再生工艺相兼容。
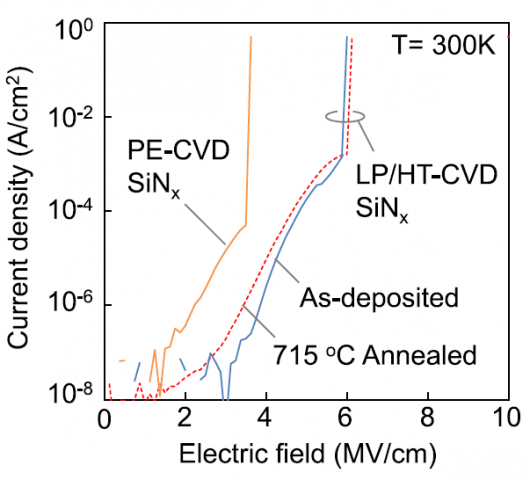
FIGURE 2. Breakdown characteristics of the LP/HT-CVD and PE-CVD SiNx layers. Breakdown behavior for LP/HT-CVD SiNx layer underwent high temperature process was also investigated. The measurement was conducted using an MIS structure with a 40-nm-thick SiNx layer.
图2:LP/HT-CVD和PE-CVD SiNx层的击穿特性,并对LP/HT-CVD SiNx层的高温击穿行为现象进行了研究。测量是在具有40 nm厚SiNx层的MIS结构进行
此外,我们通过x射线反射率测试研究了SiNx层的薄膜密度。结果表明,PE-CVD SiNx的密度从2.5 g/cm3增加到了LP/HTCVD SiNx的3.0 g/cm3。LP/HT-CVD SiNx的密度与Si3N4相似,为3.17g/cm3。我们认为,高温生长增加了SiNx薄膜的密度,减少了薄膜中的空隙,增加了击穿场强。事实上,以往文献中已经讨论了增加膜密度和减小泄漏电流的问题,其结果与我们的结果相对吻合。
因此,我们将LP/HT-CVD SiNx层用于AlN单晶衬底上的HEMT器件,并将击穿电压与先前报道的HEMT器件进行比较。图3显示了三端击穿测量过程的栅极泄漏行为。在100V以下观察到栅极泄漏电流的增加。在一个相对较低的偏置电压区域,简单的电子穿透肖特基栅占主导地位。因此,我们相信,与文献中的HEMT器件相比,带有LP/HT-CVD SiNx层的HEMT器件中2DEG密度的增加是导致栅电极周围电场聚集的原因。使用具有高击穿场强的LP/HT-CVD SiNx时,击穿电压从225提高到258 V,表明栅极电场极板角附近的击穿电压成功提高了。与图2中确认的SiNx击穿场强较大改进相比,可以预期关断态击穿电压有更大的改进。我们相信,与SiNx层的击穿场强的改进相比,HEMT的击穿电压改进较小是由于2DEG密度增加导致的电场聚集增加所致。
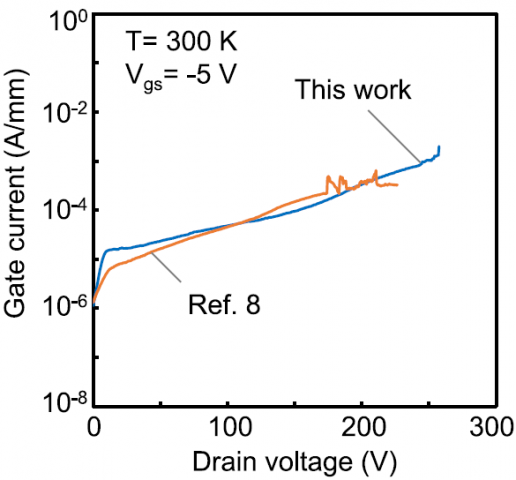
FIGURE 3. Three-terminal breakdown behavior obtained for the HEMTs with PE-CVD and LP/HT-CVD SiNx. The measurement for the HEMT with PE-CVD was carried out for the device reported in [8].
图3:PE-CVD和LP/HT-CVD SiNx HEMT器件的三端击穿行为(采用文献报道的HEMT器件进行了PE-CVD的器件测试)
图4比较了本研究的HEMT器件与文献的HEMT器件Id-Vgs曲线。漏极电流增加了约33%,这一结果归因于与文献中的HEMT器件相比,薄层电阻和接触电阻都降低了。为了确认薄层电阻和接触电阻降低的影响,我们进行了Silvaco TCAD仿真,仿真得到的Id-Vgs曲线如图4所示。文献中的HEMT器件采用的实验得到的薄层电阻和接触电阻分别为350 Ω/sq和0.33Ωmm。通过假设Rsh降低为283Ω/sq,仿真得到漏极电流增加25%,通过减小接触电阻,漏极电流进一步增加10%。预期的漏极电流增加与图4所示的Id-Vgs曲线非常吻合。

FIGURE 4. Id–Vgs curves of the HEMT developed in this study and the HEMT reported in [8]. Simulated Id-Vgs curves assuming the reduced Rsh and Rc are also shown.
图4:本研究和文献报道的HEMT器件的Id-Vgs曲线,同时显示了假设降低Rsh和Rc的模拟Id-Vgs
通过进行脉冲Id-Vds测试,以评估Id坍塌行为。图5显示了本研究开发的HEMT器件和文献报道的HEMT器件的脉冲Id-Vds测试结果。通过增加最大漏极电流,我们证实,与文献中的HEMT器件相比,具有偏置应力的漏极电流也显著增加。在漏极电压为5V时,通过将有偏置应力的Id除以无应力的Id来评估两个器件之间漏极电流的降低。在偏置应力Vgs=−5V和Vds=0V下,本研究和文献中的HEMT器件分别观察到6%和10%的漏极电流减少。在偏置应力Vgs=−5V和Vds=30V下,两个器件的漏极电流分别降低了20%和25%。还应注意到,在漏极偏置应力下观察到膝处电压明显增加,这表明在漏极沟道区域的电子陷阱起了作用。这些结果表明,尽管在n-GaN再生过程中SiNx层经历了严重的热应力,但LP/HT-CVD SiNx的HEMT器件电流崩塌并未恶化。先前有报道使用PE-CVD和LP-CVD SiNx对SiNx/AlGaN界面进行了详细的研究,他们得出结论,通过LPCVD沉积高密度SiNx膜,获得了坚固的SiNx/AlGaN界面。因此,我们认为高密度LP/HT-CVD SiNx钝化层的使用对于具有n-GaN再生过程的HEMT器件尤为重要,因为SiNx层将经历超高温制程。

FIGURE 5. Pulsed Id–Vds measurement for the HEMTs (a) developed in this study and (b) reported in [8]. The pulse width was 1 μsec, and the pulse period was 1 msec.
图5:HEMT器件的脉冲Id-Vds测试 (a)由本研究开发,(b)由文献报道。脉冲宽度为1µs,脉冲周期为1 ms
图6(a)显示了LP/HT-CVD SiNx和再生欧姆接触下AlN单晶衬底基HEMT器件在X-band的输出功率特性。负载测量在8 GHz频段进行。该器件的总栅极宽度为1 mm,负载测试下的脉冲宽度和占空比分别为10 μs和1%。在本研究中,HEMT器件的测量ft和fmax分别为24.1 GHz和52 GHz。偏置电流设置为10 mA/mm,并以最大输出功率(Pout)进行测量,工作电压为110v。峰值PAE效率为46.8%,相应输出功率Pout为43.9 dBm,相当于24.4 W/mm,线性增益为10.5dB。图6(b)显示了不同工作电压下的饱和输出功率密度(Psat)。我们成功地实现了110V的高压工作,由于LP/HT-CVD SiNx和n-GaN再生欧姆接触的击穿场增加,这远超过已有文献报道的AlN单晶衬底上的HEMT器件。Psat随Vds的增加而线性提高,在X-band成功达到24.4 W/mm。
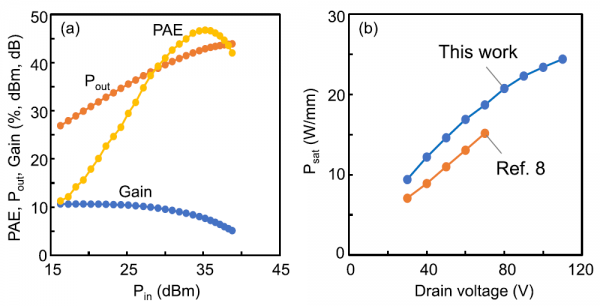
FIGURE 6. (a) RF power characteristics of the AlGaN/GaN HEMT on AlN substrates and (b) saturated output power density depending on the drain voltage. The measurement was carried out at 8 GHz.
图6:(a) AlN单晶衬底基AlGaN/GaN HEMT器件的射频功率特性和 (b)随漏极电压变化的饱和输出功率密度。该测量在8GHz频段进行。
图7列出了已有文献报道的X-band GaN HEMT器件在不同工作电压下的射频输出功率。值得注意的是,AlN单晶衬底基GaN HEMT器件中,输出功率密度最高为本研究24.4 W/mm,而在无数SiC单晶衬底基GaN HEMT器件文献报道中,很少有超过20 W/mm的。这一结果证实AlN单晶衬底基GaN HEMT器件的巨大潜力。

FIGURE 7. Benchmark of the RF output power density versus operation voltages of GaN HEMTs in X-band.
图7:已有文献报道的不同电压X-band GaN HEMT器件射频输出功率密度
图8显示了不同栅极长度下的GaN HEMT器件最高水平的JFOM优值(J-FoM=ft×击穿电压)。对于本研究开发的HEMT器件,从24.1 GHz的测量ft和258 V的击穿电压计算出J-FoM优值为6.22 THz V。如图8所示,所获得的J-FoM优值与之前报道的最高性能GaN HEMT器件相当,并且高于GaN单晶衬底上的GaN HEMT器件。此外,我们认为通过优化Al组分和AlGaN势垒层的厚度,J-FoM优值还有巨大提升空间,从而我们预期可以提高高频性能。我们认为获得的高J-FoM优值也体现了AlN单晶衬底基GaN HEMT器件的巨大潜力。
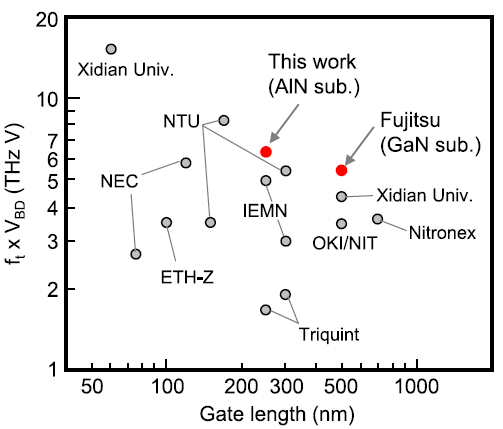
FIGURE 8. FIGURE 8. Benchmark of ft x breakdown voltages versus gate length of GaN HEMTs.
图8:不同栅极长度的GaN HEMT器件的ft×击穿电压值
结论
我们利用高密度二维电子气沟道、再生欧姆触点和高击穿场的LP/HT-CVD SiNx钝化层,在AlN单晶衬底上成功地实现了高功率射频X-band AlGaN/GaN HEMT器件。结果表明,LP/HT-CVD SiNx的击穿场高达6.0 MV/cm,远高于PE-CVD SiNx的3.6 MV/cm,从而提高了HEMT器件的击穿电压。采用了三级极化控制缓冲层结构和n-GaN再生欧姆接触,使最大漏极电流增加了约40%。大信号射频测试显示,在110v高压下输出功率密度为24.4 W/mm。
原文源于【AIP Publishing】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)