原文标题:
AlN: Opening doors with low-temperature epitaxy
- By delivering record electron and hole concentrations in AlN, low-temperature epitaxy promises to unleash a new generation of extreme bandgap devices
原文作者:
Christopher Matthews, Habib Ahmad, Keisuke Motoki, Sangho Lee, Aheli Ghosh, Emily Marshall, Amanda Tang and W. Alan Doolittle, Georgia Institute of Technology
原文刊登于“Compound Semiconductors”英文版,可参考W.Alan Doolittle部分文献及本文结尾文献:
Advanced Materials:
https://doi.org/10.1002/adma.202104497
Journal of Applied Physics:
https://doi.org/10.1063/5.0086314
Applied Physics Letters:
https://doi.org/10.1063/5.0156691
项目主要资助方:
美国海军研究办公室(the Office of Naval Research)多学科大学研究计划,项目资助编号: No. N00014-17-S-F006;
美国空军科学研究办公室(the Air Force Office of Scientific Research),项目资助编号:FA9550-21-1-0318
今天的材料无法满足明天的需求。这并不表明GaN和SiC没有取得巨大的成功—它们正在改变电力电子领域,并使固态照明成为现实。然而,这些宽带隙材料在用于电网规模和电动汽车的高功率电力电子器件时存在其局限性,且不能用于制备灭菌消毒和光刻用的深紫外光电器件。
近年来,许多具有更宽禁带宽度的半导体材料在这些领域展现出了巨大的潜力,包括氧化镓、金刚石以及氮化铝。然而,使用这些材料在器件实现层面上并不容易。尽管氧化镓有许多优点,包括4.9eV的禁带宽度、高临界电场和与低成本的生长方法,但仍存在一些弱点:由于只有n型掺杂,因此氧化镓器件仅限于单极型,且热导率很低,这些因素限制了其在电力电子器件领域的应用。金刚石的带隙高达5.5eV,得益于其高导热性和其它优异的材料特性,金刚石衬底取得了令人瞩目的进展,但金刚石衬底生产成本高昂,且掺杂仍然非常困难,同时其间接带隙特点使其不适合光电器件的应用,而光电器件应用是推动早期投资和研究其它半导体(例如GaN)的主要推动力。
几十年来,直接带隙的超宽禁带半导体氮化铝引起了科学家的强烈兴趣,这要归功于其禁带宽度高达6.1eV、临界电场为15.4V/cm、导热率为319W/mK等,且与已建立的氮化物半导体基础设施兼容。但是,生长及掺杂氮化铝仍是一项巨大挑战。
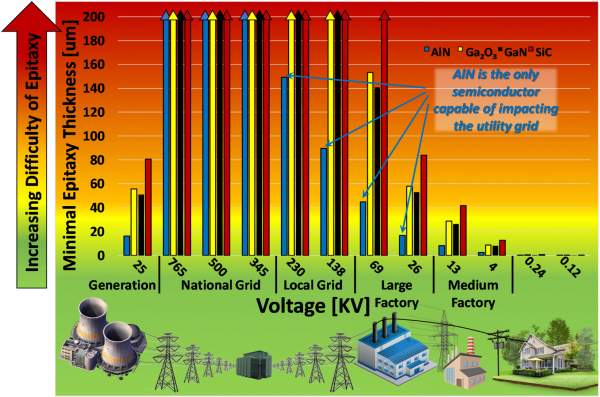
图1电网传输各节点所需的最小电压与器件厚度的关系(基于Tsao等人的理论击穿场强参数,Adv. Electron. Mater. 4 1600501 (2018))。对于半导体器件来说,厚度低于200μm被认为是合理的,但是,对于更高的电压传输应用,基于许多材料的器件厚度是非常不合理的,而氮化铝是唯一在230kV和138kV两个变电站级别应用中兼容的材料。即使对于较低的电压,氮化铝器件所需的厚度最少,有利于大规模减少器件/设备尺寸并提升其经济性。
2020年之前,氮化铝领域报告的载流子浓度对于空穴限于约1010 cm-3,对于电子限于约1015 cm-3。佐治亚理工学院的团队通过金属调制(MME)低温分子束外延工艺突破了这一限制。通过使用MME,分别实现了氮化铝中的Be和Si掺杂,获得了大大超过先前报道值的载流子浓度—远高于1018 cm-3(即p型掺杂浓度提高了约3000万倍,n型掺杂浓度提高了约6000倍)。以下详细阐述低温MME是如何实现这一成功的。
外延方面考量
在III-氮化物半导体中,掺杂效率很大程度上受点缺陷浓度的影响,它们包括:杂质原子,通常为氧、碳和氢;阳离子空位;氮空位(AlN中的VAl和VN)和可重构的缺陷,例如DX-Center。因此,限制杂质和空位形成是至关重要的,尤其是在尝试掺杂高度绝缘的氮化铝衬底材料时。这些杂质来自各种来源,并与生长技术密切相关。对于O和C杂质,有两种相互竞争的热机制在起作用:较高的温度增加了从生长腔室内释放的这些元素的浓度,但这在一定程度上被它们在半导体表面上的粘附系数的同步降低所抵消。为了限制外延生长中O/C的掺入,通常在径向温度下进行生长-即尽可能低或高的温度。
对于III-氮化物外延,空位形成通常被认为仅与III/V(或V/III)比值相关,其中VAl发生在N-rich生长中,VN发生在金属-rich生长中,主要物质通量用于替换由于吸附而损失的原子。更普遍的是,空位缺陷浓度与温度成指数关系,因此降低温度是一种有效的策略来降低空位缺陷浓度方法。
一种径向方法示例是金属有机物化学气相沉积(MOCVD)。这种外延生长技术利用高温并热力学上产生高浓度的VN。然而,从动力学上看,MOCVD中使用的大V/III比值会随着这些VN的产生而取代它们。相反的方法即低温方法,通过消除热力学驱动力来避免产生大量的表面空位缺陷浓度。因此,即使高的富铝III/V比值,也会导致VN浓度较低,而与所使用的物质通量无关。在大多数情况下,化合物半导体层的外延生长是在该材料可能的最高温度附近进行的,这通常有助于促进平整的薄膜生长。对于III-氮化物,这种方法已被用于优化氮气富集条件下的薄膜生长。然而,对于金属富集生长在物理上有一个被忽视的戏剧性转变。从本质上讲,氮气富集条件下需要高温来克服大的表面结合能势垒并促进长程吸附原子跳跃,这对于平整薄膜的形成至关重要。当吸附原子存在于金属富集表面时,这些势垒要低得多,从而确保在更低的温度下实现类似的扩散。

图2: 跳跃速率和表面扩散长度与各种原子扩散途径势垒之间的代表性计算。即使在低生长温度下,双层镓中的氮也具有大约1µ的扩散长度。
当比较在不同极性的GaN外延生长中限制性反应物的扩散长度时,很容易看出这些因素在起作用。对于氮极性的GaN表面,镓的扩散壁垒在1.4eV和1.8eV之间;相比之下,镓极性表面上的氮扩散壁垒仅为0.7eV,而双层镓中氮的表面扩散势垒低至0.12eV。由于这些变化,金属富集生长的吸附原子表面扩散长度(超过3微米)明显高于氮富集生长,即使在更低的温度下。基于上述分析,重新考虑是否使用高温生长条件是值得的。毕竟,在金属富集条件下,可以在低温下实现高质量的III-氮化物薄膜,而高温生长有几个缺点:由于生长炉内的脱气会增加杂质的产生;会发生更大的热膨胀,引入不需要的应变;并且掺杂效果会受到影响。
但是,掺杂并不像降低生长温度并仅使用金属富集条件那样简单。如果采用这种方法,会导致金属液滴的过量积累,并最终对III-氮化物外延薄膜质量产生不利影响。因此,需采用一种在金属富集和氮富集生长条件之间进行交替调制生长的技术。这种技术通常作为分子束外延生长(MBE)的一种变种工艺,即利用金属富集生长的优势并限制多余金属的积累。在这些改良的生长方法中,最重要的是金属调制工艺(MME)。在这种外延生长中,金属通量比氮通量多30%至200%。该过程的一个关键工艺是物理屏蔽金属源,采取的方式是通过周期性去除所有金属积累实现平均时间生长条件的氮富集(参见图3)。当金属源快门打开时,表面迅速形成金属吸附层,积累持续直到金属源快门关闭,此时金属吸附层被连续供应的活性氮消耗。一旦金属吸附层完全耗尽,薄膜暂时停止生长,直到金属源快门重新打开,循环重复。然而,由于生长反应仅取决于表面吸附的金属量,而不是金属通量,生长几乎总是在金属富集条件下进行的。

图3 金属调制外延生长中典型通量随时间变化图,瞬时金属通量(φIII)高于氮通量(φN),确保在富含金属的条件下生长,平均时间金属通量(φIII,avg)低于(φN),消除了液滴积聚。
佐治亚理工学院团队于2007年开发了上述MME工艺。从那时起,我们使用这种外延技术在III-氮化物中取得了许多令人印象深刻的结果,包括:近10微米/小时的生长速率;InGaN/AllnN互溶间断区无相分离的单相三元III-氮化物;在GaN中实现电子浓度高于1020 cm-3的高n型掺杂;在GaN中实现空穴浓度高于6×1019cm-3的p型掺杂;GaN中的隧道结实现极低的电压降(0.14 V),其中AlGaN合金中Al的含量高达60%。请注意,所有这些成功都是在不牺牲薄膜质量的情况下实现的。典型的MME工艺生长出的外延薄膜具有出色的X射线衍射性能(即摇摆曲线半高宽与衬底材料一致)以及低于1nm粗糙度的光滑平整薄膜表面质量,这在多种器件中已得到证明。
最初,我们的结果,特别是掺杂的成功,相当有争议,因为它们与通过传统方法生长的III-氮化物的理解不相容。例如,先前的理论和实验结果表明,镁在GaN中有深的受主激活能,限制了空穴浓度,但我们发现使用MME工艺生长的薄膜存在浅的受主激活。这一发现令人惊讶。经过进一步研究,我们意识到理论分析往往只考虑掺杂水平接近掺杂杂质溶解度的平衡极限,这一限制导致带隙中深且孤立的受主态。而MME生长工艺是动力学受限的,允许偏离平衡条件,特别是掺杂远超过其溶解度极限时。结果是掺杂剂可以高于溶解度极限被强制进入薄膜,当浓度特别高时,这些掺杂剂的玻尔轨道开始重叠,形成掺杂带。对于GaN中的镁掺杂,受主带的形成将有效激活能从约210meV降低到50meV,这导致空穴浓度接近1×1020cm-3。从这项工作出发,我们在高达60%的Al组分的AlGaN中发现了受主带,这一发现为研究AlN的掺杂提供了基础。
AlN的p型掺杂
我们考虑了三种潜在的p型AlN掺杂剂:其中两种是阳离子替代的镁(MgAl)和铍(BeAl),另一种是阴离子替代的碳(CN)。镁是天然的首选,由于它被用作GaN的主要p型掺杂剂。然而,在镁掺杂的AlN中报告的最高空穴浓度小于1010 cm-3。理论研究表明,镁是激活能为510-630meV的深能级受主。虽然这种掺杂剂有可能形成镁受主带,但实际不太可能。AlN中镁的溶解度较低,这来自Al(118pm)和Mg(145pm)之间大的原子半径不匹配。有报道称,随着AlGaN中Al含量的增加,镁掺杂对空穴产生的效率降低,因此平均阳离子尺寸减小。
碳同样是一种不切实际的掺杂剂,但与上述原因不同。虽然有报道称在碳掺杂的AlN中存在有限的表面水平p型传导,但这种掺杂剂尚未实现在AlN中提供大量的空穴浓度,并且通常被理解为AlN中的补偿杂质。另一个主要问题是,由于金属有机源中的碳浓度不一致,MOCVD生长的III-氮化物中的碳浓度在运行之间是不稳定的,这种不受欢迎的变化会使碳掺杂难以控制。
上述原因使得Be成为最有希望的p型AlN掺杂剂。虽然它也被预测为一种深能级受主,具有220-340meV的激活能,但它没有碳和镁那样的困扰。与镁不同,铍的原子半径相当小,因为铍的半径为112pm。因此,铍在AlN中的高溶解度使得受主带的形成成为可能。我们最近的研究支持这种可能性,我们的研究结果表明铍掺杂的AlN中室温空穴浓度为4.4×1018cm-3,同时有效激活能为37 meV (见图4)

图4 P型AlN的温度相关霍尔测量显示出37meV的激活能,结果由Lake Shore Cryotronics公司的Jeff Lindemuth进行此次测量
基于诺贝尔奖得主、凝聚态物理学家Neville Mott博士与W.D. Twose的合作研究,可以估计开始形成能量带的临界掺杂浓度。对于AlN中的铍浓度可预测为惊人的4x1021cm-3,相当于4%的杂质含量。为什么值这么高?这是因为在计算中假设了AlN的价带结构与其他III-氮化物相似—而实际上并非如此。对于AlN,分离带具有更大的曲率,并且在能量上比重空穴带和轻空穴带更接近导带。因此,AlN中的最低能量空穴具有比其他III-氮化物中的低得多的有效质量。一旦考虑到这一点,受主带形成的临界掺杂浓度被修正为仅为1.2x1018 cm-3。这个值与实验证据一致,这表明只有在铍浓度超过1017cm-3范围时,才能测量到p型导电,此时存在足够多的空穴以允许可观的电流接通。
尽管我们取得了成功,但AlN的铍掺杂仍存在一些挑战,主要与生长温度有关。我们最大的与生长温度相关的问题是铍具有中等蒸气压,因此很容易被解吸,即使在相对较低的生长温度下也是如此(刚刚超过750°C),而高温下生长铍掺杂的AlN会导致铍掺入量减少和空穴浓度降低。增加铍通量也不是一个选项,因为在生长室内过多的铍解吸可能导致铍失控,使生长室本身成为不可控的铍源。在用铍掺杂AlN时,另一个重要的考虑因素是限制薄膜中可能出现的补偿型缺陷数量,如VN和O,后者特别容易被Al和Be吸引,并可能形成ON和Be-O缺陷复合体。如前所述,可以通过适当调节MME生长条件来限制VN缺陷,并通过低温下生长来降生长炉内金属组件脱气导致的氧生成速率。铍带来的另一个问题是,由于其体积小—它略小于铝阳离子—它可以在晶格中进行物理重构,从BeAl受主转变为补偿型Be间隙缺陷。由于热膨胀的原因,这种重构更可能发生在高温生长的外延薄膜中,这也是在低温下生长p型AlN至关重要的又一个原因。
AlN的n型掺杂
潜在的掺杂剂是阴离子取代的氧(ON)和阳离子取代的硅(SiAl)。然而,我们可以迅速排除氧,因为当它与大量的VAl结合形成带负电的复合缺陷时,它只能在AlN中产生浅施主,这限制了其应用。幸运的是,MME硅掺杂一直比较简单,MME工艺可以实现的电子浓度高达6×1018cm-3,这比以前的最佳水平提高了近6000倍。虽然硅的蒸气压比铍低得多,因此在典型的III-氮化物生长温度下不会解吸,但似乎MME的低生长温度仍然起着至关重要的作用,硅掺杂得益于低温和金属富集的生长条件。硅掺杂AlN的主要问题是Si-DX Center的形成,其形成于SiAl原子与其相邻氮原子之间的c轴键断裂期间。与铍掺杂类似,较高的生长温度是不希望的,因为它们可能导致更大的热膨胀并促进不希望的晶格重构。此外,VAl缺陷的存在可以“软化”晶格,使这类DX Center更容易形成。为了解决这个问题,我们已经讨论过的使用金属富集生长的方法可以大大降低VAl形成的可能性。迄今为止,尝试掺杂AlN的最常见方法是MOCVD,这种方法需要高温和氮气富集的生长条件,而这两者都是实现高硅掺杂效率的障碍。另一个障碍是MOCVD生长的薄膜中不可避免的碳补偿性质。考虑到所有这些因素,也许能以如此大的优势超越以前n型AlN的最佳状态并不奇怪。
器件开发
借助MME在AlN中产生相当高的空穴和电子浓度的能力,我们已经证明了p-i-n二极管的整流作用。我们初步的二极管显示出高于此前六个数量级的整流性,近6V的理想开启电压,以及高达2.8A/cm2的电流密度。这些器件的性能主要受正向偏置时高串联电阻的限制,这可能源于需要解决的与这些准垂直二极管的蚀刻n型表面的接触问题。我们关于高接触电阻的初步理论包括当将6.1eV带隙材料与功函数限制在2.8eV至5.8eV的金属接触时的一个基本问题,以及非优化等离子体蚀刻对n-AlN薄膜的损伤。我们对这些二极管进行了温度相关的电流-电压特性分析,发现在开启电压以上存在热激活过程。在低于开启电压的情况下,电流与温度无关,这表明接触主导了隧道效应而不是传统的欧姆导电。我们需要进一步对制备的二极管进行研究,以便确定决定AlN二极管电气特性的物理过程。这些努力必须包括建立更好的接触解决方案,这将消除分析电流-电压曲线时的复杂性,并开发出更高电流密度的器件。

图5 AlN外延生长中采用MME技术能实现高浓度n/p掺杂能力,制备的AlN基p-i-n二极管具备高于此前六个数量级的整流性
低温外延在实现高掺杂的p型和n型AlN以及AlN基二极管方面起着至关重要的作用。低温允许铍和硅掺杂剂在不重构补偿中心的情况下并入AlN薄膜中,并限制了AlN中产生补偿空位缺陷的数量,并减少了从生长室结构组件中解吸的补偿杂质(如碳和氧)的浓度。由于金属富表面上的吸附原子具有大的扩散长度,可以在这些低温下进行富金属真空工艺,同时不会牺牲这些外延薄膜的生长质量。通过避免掺杂剂解吸产生的复杂情况,铍以足够高的浓度并入AlN薄膜中以形成受主能级,大大降低了有效激活能并改善了p型AlN的可行性。这种材料掺杂组合的另一个好处是,由于AlN的独特价带结构,杂质能级在铍浓度远低于GaN的情况下形成确保更高的空穴迁移率。
对MME生长的p型和n型AlN外延薄膜的测量显示,载流子浓度分别为4.4 x1018cm-3和6x1018cm-3,电阻率分别为0.045Ωcm和0.02Ωcm。在相同载流子浓度下,我们还创记录的实现了AlN的空穴迁移率比GaN高出十倍,这表明AlN可以为p型器件提供更多的前景。虽然仍需做大量工作,但有令人鼓舞的迹象表明,AlN为寻找一种能够满足未来电子和光电子性能需求的材料提供了解决方案。
1) J. Y. Tsao et al. “Ultrawide-Bandgap Semiconductors: Research Opportunities and Challenges” Adv. Electron. Mater. 4 1600501 (2018)
2) M. A. Khan et al. “III–Nitride UV Devices” Jpn. J. Appl. Phys. 44 7191 (2005)
3) C. Stampfl et al. “Theoretical Investigation of Native Defects, Impurities, and Complexes in Aluminum Nitride” Phys. Rev. B 65 155212 (2002)
4) J. L. Lyons et al. Effects of Hole Localization on Limiting P-Type Conductivity in Oxide and Nitride Semiconductors, J. Appl. Phys. 115 012014 (2014)
5) G. A. Slack et al. Some Effects of Oxygen Impurities on AlN and GaN, Journal of Crystal Growth, 246 287 (2002)
6) W. A. Doolittle et al. Prospectives for AlN Electronics and Optoelectronics and the Important Role of Alternative Synthesis, Appl. Phys. Lett. 123 070501 (2023).
7) H. Ahmad et al. Realization of Homojunction PN AlN Diodes, J. Appl. Phys. 131 175701 (2022)
8) H. Ahmad et al. Comprehensive Analysis of Metal Modulated Epitaxial GaN, ACS Appl. Mater. Interfaces 12 37693 (2020)
9) Y. Taniyasu et al. An Aluminium Nitride Light-Emitting Diode with a Wavelength of 210 Nanometres, Nature 441 7091 (2006)
10) T. Ive et al. Controlled N-Type Doping of AlN:Si Films Grown on 6H-SiC(0001) by Plasma Assisted Molecular Beam Epitaxy, Appl. Phys. Lett. 86 024106 (2005)
11) P. Bagheri et al. Doping and Compensation in Heavily Mg Doped Al-Rich AlGaN Films, Appl. Phys. Lett. 120 082102 (2022)
原文源于【Compound Semiconductors】文献
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)