原文题目:3 kV AlN Schottky Barrier Diodes on Bulk AlN Substrates by MOCVD
原文作者:Dinusha Herath Mudiyanselage, Dawei Wang, Ziyi He, Bingcheng Da, and Houqiang Fu, Arizona State University
原文链接:https://doi.org/10.48550/arXiv.2311.05130
项目资助方:美国能源部(U.S. Department of Energy)、美国国家自然基金(U.S. National Science Foundation)。
引言
氮化铝(AlN)具备优异性能,是电力电子器件领域极具应用前景的超宽禁带半导体材料,如其禁带宽度高达6.2eV、击穿场强高达12-15MV/cm及340W/m•K的高导热系数,这些特性导致Baliga品质因数是电力电子应用中使用的其他材料(如GaN和SiC)的30多倍。近年来,AlN基肖特基势垒二极管(SBDs)在1kV击穿电压和高温稳定性方面取得了不错的进展。如Irokawa等人在非故意n型掺杂的AlN单晶衬底上实现了横向AlN基SBDs,其高温稳定性高达573 K。然而,这些器件理想因子高达11.7,表明电子传递机制偏离了众所周知的热离子发射(TE)模型。Kinoshita等人通过去除用于生长氢化物气相外延(HVPE)AlN外延层的种子层,开发了垂直AlN基SBDs。这些二极管能够实现550-770V的击穿电压,理想因子优化至8。然而,由于缺乏导电型AlN衬底,用于制造垂直AlN基 SBDs的衬底去除工艺可能会导致器件损坏。Fu等人报道了击穿电压超过1kV的横向AlN基 SBDs,展示了AlN基电力电子器件的潜力。Maeda等最新研究了基于分子束外延法(MBE)制备出AlN基 SBDs,该器件具有良好的热稳定性和非均匀分布的肖特基势垒。研究表明,氮化铝外延薄膜的缺陷对正向和反向电流传输影响显著,提升AlN器件性能的关键是减少材料中的缺陷。
目前,HexaTech和Crystal IS及奥趋光电等企业已经商业化了物理气相传输法(PVT)生长的AlN单晶衬底,其位错密度在103-105 cm-2量级,从而通过MBE和MOCVD(金属有机化学气相沉积)可生长出高质量的AlN外延层,后者可运用于大规模量产。在这项工作中,我们首次通过MOCVD在AlN单晶衬底上实现了具有优异高温性能的3kV AlN基SBDs。器件具有良好的整流性能,在298-623K范围内的开关比为106-108,具有良好的热稳定性。该器件击穿电压高达3kV,且在没有使用任何场板结构或钝化的情况下,漏电流仅为200nA。该研究工作为研制多千伏AlN基高压大功率器件奠定了基础。
生长、材料表征和器件制备
采用MOCVD法在PVT法AlN单晶衬底(0001)晶面上生长AlN外延层。Al和N源分别采用三甲基铝(TMAl)和氨(NH3),n型掺杂剂Si采用N2稀释的硅烷(SiH4)。器件结构如图1(a)所示,由1μm厚的非故意掺杂(UID) AlN层作为阻性缓冲层,200nm高硅掺杂n型AlN层和2nm的UID GaN封盖层组成。GaN封盖层用于防止暴露在空气中的AlN外延层氧化,从而降低器件性能。n型AlN层中Si掺杂浓度为1×1019 cm-3。为了研究MOCVD生长的AlN样品的晶体质量,使用Rigaku SmartLab X射线衍射仪系统进行了高分辨率X射线衍射(HRXRD)测量,图2(a)和2(b)显示了AlN样品的(0002)对称和(1012)不对称摇摆曲线(RCs),(0002)和(1012)的全宽半最大值(FWHM)分别为17.6 arcsec和19.08 arcsec,位错密度预计在104-105 cm-2之间。此外,使用Bruker's Dimension原子力显微镜(AFM)对AlN样品的表面形貌进行了观测,结果显示,在2×2μm2扫描区域内的均方根(RMS)粗糙度约为1.2nm。HRXRD和AFM结果表明,MOCVD生长的AlN外延层具有较低的位错密度和光滑的表面。在超声波的辅助下,用丙酮、异丙醇和去离子水清洗样品。随后,将其浸入1:2(HCl:H2O)比的盐酸(HCl)溶液中。AlN SBD的制备采用传统的光学光刻和剥离工艺。采用电子束沉积Ti/Al/Ti/Au(25/100/25/50 nm)金属堆形成欧姆接触,然后在1000°C N2中快速热退火(RTA)1分钟。圆形欧姆接触的宽度为100μm,如图1(b)所示。对于肖特基触点,通过电子束蒸发沉积Pt/Au(30/120 nm)金属堆。阳极和阴极触点之间的距离在50-350μm之间变化,器件上没有电场板、钝化或边缘终端结构。电性能测量是在配备了Keithly 4200 SCS的半导体分析仪和热卡盘的探针测试台上进行的。反向I-V特性采用Keysight B1505A功率器件分析仪/曲线示踪仪进行测量,并在室温下绝缘氟化液体FC-70中进行反向击穿测量。
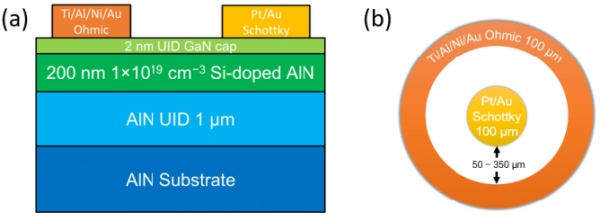
图1:(a)AlN基SBD示意图,采用MOCVD法在AlN单晶衬底上制备Ti/Al/Ni/Au欧姆接触、Pt/Au肖特基接触;(b)器件俯视图

图2:AlN外延层HRXRD (a)(0002) 和 (b)(1012) 摇摆曲线
结果与讨论
图3(a)显示了AlN基SBD的正向I-V特性。器件的开关比为105-106,导通电压为2.5 V,与先前报道的AlN基SBDs相当,并表明载流子浓度相对较低,当前的输运机制可能受到AlN外延层表面状态和/或电阻的影响。图3(b)为不同温度下AlN基SBD的I-V曲线。器件在298-623K范围内表现出良好的温度稳定性,器件的开关比从106增加到108,因为更多的载流子有助于在更高温度下实现电流传输。
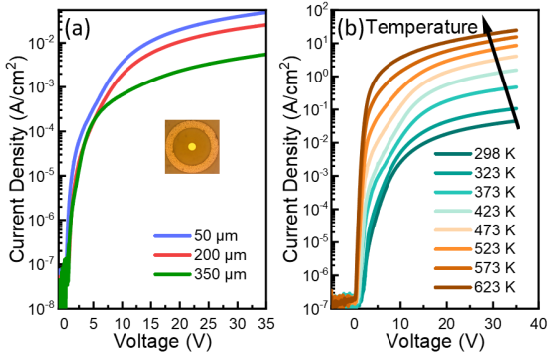
图3 (a)不同接触距离下AlN SBD在对数尺度上的正向I-V特性,插图:AlN器件的光学图像;(b)接触距离为50μm时AlN SBD正向I-V特性随温度的变化曲线。
图4(a)显示了AlN基SBD(接触距离50μm)的温度依赖变量:肖特基势位能高度和理想因子。随着温度的升高,肖特基势位能高度从0.89eV增加到1.85eV,理想因子从4.29减少到1.95。图4(b)显示了器件肖特基势位能高度和理想因子间的线性关系。这可以归因于具有低/高肖特基势垒区分布的非均匀金属/AlN界面。这种现象在此前的报道中也经常被观察到,随着温度升高,电子可以克服更高的肖特基势垒区,从而导致肖特基势位能高度的增加。此外,随着温度的升高,器件表现出与TE模型更接近的情况,如理想因子的减小。
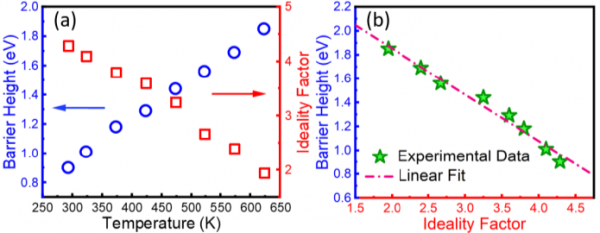
图4 (a) AlN SBD的理想因子和肖特基势垒高度随温度的变化;(b)肖特基势垒高度与理想因子关系拟合曲线
此外,C-V测量可用于提取AlN外延层的载流子浓度。图5(a)为器件的C-V和1/C2-V图。器件的C-V测量在10kHz进行。1/C2-V图有两个区域,分别对应AlN UID层和n掺杂AlN。UID层提取的载流子浓度为2.3×1016cm-3,而n掺杂区域的载流子浓度为5.7×1017cm-3,由于掺杂剂在AlN中的补偿作用远小于Si掺杂浓度,导致AlN中Si施主电离能较高。图5(b)显示了通过插图中器件的C-V测量所提取的载流子浓度随温度变化情况。随着温度升高,载流子浓度在5.7×1017-1.6×1018cm-3之间从298-623K变化。随着温度的升高,更多的载流子被激活,从而可观察到额外的电容。
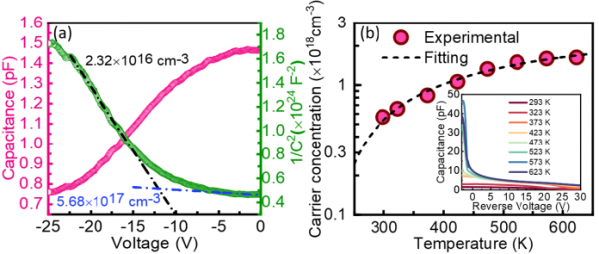
图5 (a) AlN SBD在RT下的C-V图和1/C2-V图;(b)载流子浓度随温度变化图。插图:器件的温度相关性C-V测量。
图6(a)显示了在高达3kV范围内,不同接触距离下AlN基SBD的反向I-V特性。所有器件的击穿电压均在3kV以上。应该注意的是,在3kV(电流设置的极限)以下没有观察到器件的破坏性击穿。接触距离为50μm的AlN基SBD在3kV时的反漏为200nA。反漏电流随着接触距离的增加而增加,表明表面漏电流占主导地位,并随着器件面积的增加而增加。图6(b)比较了此前报道的AlN基SBDs的击穿电压和导通电压。我们的研究表明,在最小的接触距离和相当的导通电压下,击穿电压超过3kV,创历史新高。
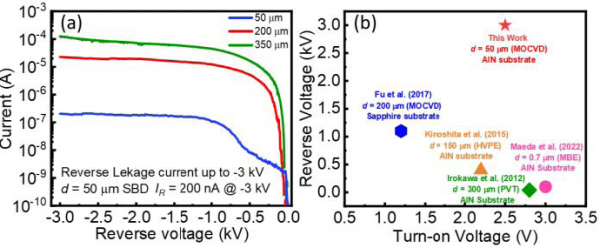
图6 (a) AlN基SBD反漏;(b)与过往所报道的AlN基SBDs的击穿和导通电压比较
结论
综上,本项研究通过MOCVD技术在AlN单晶衬底上制备出了击穿电压超3kV的横向AlN基SBDs,器件具有优异的整流性能,在298-623K范围内的开关比为106-108,具有良好的热稳定性。随着温度的升高,肖特基势位能高度从0.89eV增加到1.85eV,而理想因子从4.29减少到1.95。在3 kV时,在没有任何场板结构或钝化的情况下,器件表现出200nA的低漏电流。这些结果显示了氮化铝单晶衬底的巨大潜力,为未来氮化铝基高功率、高频及高温电力电子器件的发展奠定了重要基础。