译改自原文:Pioneering N-polar HEMTs
原文发表于:COMPOUND SEMICONDUCTOR
原文链接:https://compoundsemiconductor.net/article/116627/Pioneering_N-polar_HEMTs
原文引用自:E. Kim et al. Appl. Phys. Lett. 122 092104 (2023)
以美国康奈尔大学为首的研发团队宣称制备出基于AlN单晶衬底全球首个N极性GaN/AlGaN/AlN HEMT器件。
这一由康奈尔大学、圣母大学和旭化成联合组成的研究团队表示,此类晶体管可以有效发挥AlN材料的耐高温和高功率处理能力以及N极性器件结构的优势,比如强大的背势垒。此类具有AlN缓冲层的HEMT的另一个优势是它们无需重掺杂。相比之下,传统的GaN基HEMT需通过重掺杂以弥补外延的厚GaN缓冲层中的高非故意掺杂浓度,从而抑制缓冲泄漏电流和射频损耗。
该团队宣称AlN将用于高功率、高频和极端环境条件下的应用,这一突破得益于其近期成功开发的N极性AlN单晶衬底原位清洗技术,该技术使得AlN单晶衬底基GaN/Al(Ga)N异质结中的二维电子气得以被发现。基于AlN单晶衬底进行外延生长的优势之一是它确保了外延层的低位错密度,通常为104-105cm-2,相比之下,在SiC、硅、蓝宝石等异质衬底上生长的位错密度达到109-1010cm-2。更为重要的是,同质衬底消除了高热边界。正如在SiC中所发现的,高热边界理论上被证实会影响衬底的高热导率特性。在被问及该类衬底能否实现批量化生产时,团队发言人Eungkyun Kim评论说:“AlN单晶衬底已经证明了其作为光电、功率、射频器件高性能衬底材料的巨大潜力,我们相信随着AlN单晶生长技术的不断成熟,AlN单晶衬底的制造成本和应用空间将会大大提升。”
该团队开发的新型HEMT器件制备工艺首先将100 μm厚的旭化成N极性AlN单晶衬底置于等离子体辅助MBE设备中,并沉积1 μm厚的AlN缓冲层,随后是20 nm厚的Al0.91Ga0.09N杂质阻挡层、8 nm厚的通道层和6.4 nm厚的重掺杂GaN帽层,该结构用于实现易形成的非合金欧姆接触。在通过热原子层沉积(TALD)10nm厚的Al2O3层来保护N极性层之后,研究团队通过光刻技术定义了源极和漏极触点,并通过电子束光刻技术增加了T形栅极。
导电性检测显示,该HEMT器件的接触电阻为0.66Ωmm。据文献报道,其他N极性HEMT的接触电阻仅为0.14Ωmm,因此该团队仍需设法减小器件的接触电阻。当从长通道HEMT转到T型栅HEMT器件时,导通电阻从4.12 Ω mm下降到1.56 Ω mm,最大漏极电流从1.2A/mm增加到2.6 A/mm,这些特征表明了良好的缩放性能。与在SiC上生长500 nm Al极性AlN层的器件相比,同质外延将通过缓冲层的漏电流降低了两个数量级。该研究团队将这种优势归因于外延层中较低的位错密度。射频性能检测显示,由于高寄生源电阻和低跨导的抑制,器件的最大振荡频率为100GHz,截止频率为68GHz。
Kim坦言,第一代器件尚有许多电气性能问题亟待解决:“目前的关键是实现更高的跨导,更低的栅极泄漏和更高的击穿电压。完成该HEMT器件的电学性能优化后,我们还将深入研究其热性能,并证实通过消除生长界面的热边界电阻,可以在器件层面解决发热问题。”
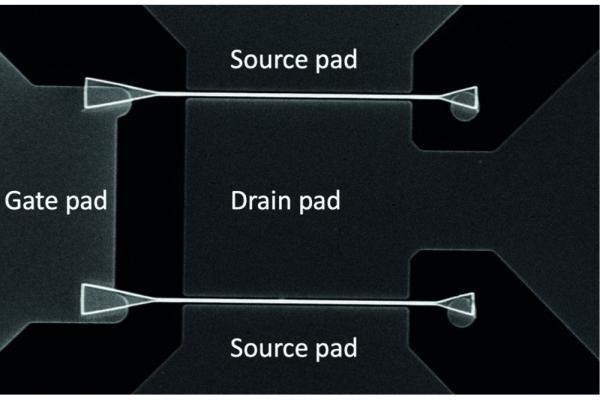
N极性HEMT器件的扫描电子显微镜图像
A scanning electron microscopy image of a fully processed N-polar HEMT.