译自原文
Low-resistance graded AlGaN contact to high Al-content AlGaN PolFET grown by ammonia molecular beam epitaxy
原文链接
https://doi.org/10.1063/5.0317039 Appl. Phys. Lett. 128, 083302 (2026)
原文作者
Ashley E. Wissel-Garcia,1, Yinxuan Zhu,2 Siddharth Rajan,2,3 and James S. Speck1
1Materials Department, University of California, Santa Barbara,
2 Electrical and Computer Engineering, The Ohio State University,
3 Materials Science and Engineering, The Ohio State University.
项目支持方
美国陆军研究办公室(ARO)、空军科学研究办公室(AFOSR)、美国国家科学基金会(NSF)
摘要
为实现适用于高频、高功率场景的超宽禁带AlGaN晶体管,必须尽可能降低高迁移率导电沟道的接入电阻,以满足高频工作需求。AlGaN材料相对较低的电子亲和能对其欧姆接触的形成构成严峻挑战。本研究报道了在极化掺杂场效应晶体管(PolFET)中,面向Al₀.₇₅Ga₀.₂₅N沟道所制备的低阻、组分梯度AlGaN接触层。样品采用氨分子束外延技术连续生长。通过对比相同梯度结构PolFET沟道上硅掺杂梯度接触层与标准合金化钒基接触层的电阻性能,并优化梯度接触层中的掺杂浓度以抵消组分梯度引起的负体极化电荷,我们实现了目前报道中最低的高铝组分AlGaN比接触电阻之一(ρc = 7.2 × 10⁻⁷ Ω·cm²)。该成果通过提升PolFET的漏极电流、降低开关损耗,有效改善了器件性能,并为超宽禁带射频电子器件的发展奠定了重要基础。
射频功率放大器是通信、雷达等无线电信号发射系统中的核心组件。这类器件需要实现高输出功率与高增益,其性能直接取决于所选半导体晶体管的材料特性。目前,氮化镓高电子迁移率晶体管在此类应用中已超越传统半导体硅和砷化镓的性能;然而,面向新兴应用场景,仍需开发新材料以进一步提升器件的输出功率极限。氮化铝镓作为一种新兴半导体材料,有望突破性提升射频晶体管的性能边界。其超宽禁带特性(Eg=3.4–6 eV)使其能够承受随铝组分增加而增大的临界电场强度,显著超越硅、砷化镓及氮化镓的击穿电场极限。同时,氮化铝镓还具有理论上较高的电子饱和速度(约1.5×10⁷ cm/s),与硅、砷化镓等常用半导体材料相当,因而成为高频器件领域极具前景的候选材料。
III族氮化物半导体因阳离子与阴离子间距的非理想性,具有自发极化与压电极化特性。在异质结构中,极化强度的差异会诱导产生二维(或三维)电子气/空穴气形式的极化诱导载流子。AlGaN/GaN界面形成的二维电子气已成为当前广泛应用的GaN高电子迁移率晶体管的基础,而采用三维电子气的器件则展现出独特优势。极化掺杂场效应晶体管(PolFET)相较于高电子迁移率晶体管具有更多设计自由度,主要体现在组分梯度的厚度与分布形态可调控,从而增强器件性能参数的可调谐性,例如跨导特性曲线及其决定的功率输出线性度。组分梯度设计在射频功率器件中的优势已在PolFET和梯度沟道高电子迁移率晶体管中得到验证,两类器件均表现出高线性度、低色散和快速开关特性。高铝组分AlGaN PolFET有望在保持这些优良器件特性的同时,兼具更高的击穿电场强度。此类器件虽已有初步实现,但早期器件存在输出电流低(远低于1 A/mm)和截止频率不足的问题,且少有射频性能报道。
接入电阻是指从源极接触至沟道的总电阻,包含金属接触及任何中间接触层的电阻,是当前AlGaN射频晶体管面临的主要挑战之一。其中任一环节的过大电阻都会增加器件的开关时延,导致截止频率降低。随着AlGaN中铝组分的增加,其电子亲和能下降、禁带宽度增大,使得高铝组分AlGaN层比GaN更难形成良好的欧姆接触。虽然基于钒和锆的退火接触叠层已被用于实现AlGaN的欧姆接触,但其接触电阻仍远高于当前最先进的GaN基高电子迁移率晶体管。一种正在探索的策略是采用组分梯度接触层——即通过在一定厚度内逐渐降低铝组分,使得欧姆接触得以在较低铝组分的AlGaN或GaN上实现。在梯度降低铝组分的过程中,由于起始与终止组分之间的总极化差异会形成三维空穴气,必须通过氢化施主杂质进行反掺杂来抑制该空穴气,这为实现最优接触结构引入了一个新的研究变量。尽管反向梯度层可以实现从高铝组分向低铝组分的过渡,但其在与突变异质结界面的器件集成中仍面临挑战,因为此类器件中的导带偏移会额外增加接触电阻。梯度沟道设计提供了一种巧妙的解决方案,它能将准三维电子气与反向梯度接触层无缝集成,从而消除沟道与接触层间的导带偏移势垒。本研究通过实验证明,为实现高性能射频器件,必须优化高铝组分沟道所用重掺杂梯度接触层中的施主浓度。
本研究涉及的薄膜均在加州大学圣塔芭芭拉分校通过Vecco Gen 930型氨分子束外延系统生长。所用衬底为从晶湛半导体采购的蓝宝石基AlN模板。生长腔配备标准的III族金属喷射炉、固态Si掺杂源。NH₃通过未加热的喷淋头注入器直接通入衬底区域,衬底温度经光学高温计测量,该高温计已根据衬底发射率进行校准。III族束流与NH₃的流量均通过位于衬底相同位置的离子规测量其束流等效压强进行标定。AlN与AlGaN的生长速率通过前期生长的校准样品,并借助高分辨率X射线衍射耦合ω-2θ扫描测定。实现不同AlGaN组分所需的束流条件亦通过对前期校准样品进行倒易空间映射测量确定。Si掺杂浓度通过在相同条件下生长独立校准样品,并对其进行二次离子质谱分析完成标定。生长前,蓝宝石基AlN模板的未抛光背表面通过电子束蒸发镀覆Ti/Pd/Ti(5/500/100 nm)金属层以增强衬底加热效果。随后将衬底依次置于丙酮、甲醇和异丙醇中各超声清洗3分钟,完成溶剂清洁后装入MBE进样室。样品在进样室及后续的缓冲室中于400°C下脱气至少1小时。生长开始前,立即采用我们前期工作中所述工艺对样品进行Ga抛光处理。之后,将NH₃流量设定并稳定在25 sccm。
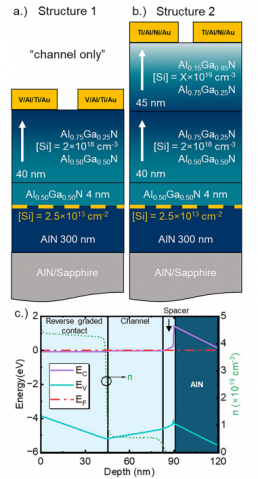
图1. 本文所讨论的外延层结构示意图。(a) 展示了仅含沟道的PolFET结构,(b) 展示了带有梯度接触层的完整PolFET结构,(c) 展示了结构 (b) 的能带图。
器件结构如图1(a)和(b)所示。首先生长了约300 nm厚的AlN同质外延缓冲层,该层同时作为两个器件的绝缘背势垒。生长过程中暂停,沉积了一层面浓度为2.5×10¹³ cm⁻²的硅δ掺杂层,随后生长4 nm非故意掺杂的Al₀.₅Ga₀.₅N隔离层。此硅δ掺杂用于抵消从AlN到Al₀.₅Ga₀.₅N突变界面产生的负极化电荷,详细原理已在另一篇文献中阐述。随后生长梯度沟道层,在40 nm厚度内从Al₀.₅Ga₀.₅N线性渐变至Al₀.₇₅Ga₀.₂₅N,并依据前期二次离子质谱校准结果掺入浓度为2×10¹⁸ cm⁻³的硅。对于具有梯度接触层的样品,该层在沟道生长后连续生长,为45 nm厚的线性渐变层,组分从Al₀.₇₅Ga₀.₂₅N渐变至Al₀.₁₅Ga₀.₈₅N,硅掺杂浓度分别为1×10¹⁹、2×10¹⁹和5×10¹⁹ cm⁻³。图1(c)展示了该异质结构的预期能带图。各样品均通过高分辨率X射线衍射倒易空间映射表征,确认AlGaN层与衬底保持共格应变。样品表面形貌通过原子力显微镜在轻敲模式下表征。随后样品送至俄亥俄州立大学进行霍尔效应测试的接触电极制备。无梯度接触层的样品采用钒基接触电极(V/Al/Ti/Au 20/80/20/80 nm),并在850°C下退火90秒。含梯度接触层的样品采用钛基接触电极(Ti/Al/Ni/Au 20/120/30/100 nm),在860°C下退火30秒。各样品均在室温下通过范德堡结构进行霍尔效应初始测量。测量后,选取导电性最佳的梯度接触层样品([Si]=1×10¹⁹ cm⁻³),采用电感耦合等离子体反应离子刻蚀进行沟道栅槽刻蚀,并再次进行霍尔效应测试以确认沟道电导率未发生变化。四端转移长度法测量使用安捷伦B1500参数分析仪完成,接触电极尺寸为30×100 μm²。最后,分别选取无梯度接触层的样品与具有最佳导电性梯度接触层的样品制备晶体管器件。晶体管制备与测量的详细内容将在另一篇工作中讨论。
图2展示了PolFET沟道结构及一种梯度接触结构的( )晶面倒易空间映射。两种结构中,梯度AlGaN层均与下方的AlN衬底保持共格应变,这通过Qz方向的峰位对齐及AlGaN衍射条纹未出现镶嵌展宽现象得以证实。原子力显微镜图像显示两种结构表面形貌光滑,均方根粗糙度较低,且可见清晰的台阶边缘。这些结果表明构成器件的外延材料具备优异的结晶质量。霍尔效应测量结果如表I所示。由于测量对象为组分梯度层,所获面载流子浓度与迁移率均为等效值(完整的多层霍尔分析超出本研究范畴)。仅含沟道的PolFET结构作为参照基准,展示了无附加接触层时的沟道本征特性。而重掺杂梯度接触层样品则表现出电子迁移率下降及载流子浓度低于预期的现象。对于掺杂浓度最高的梯度接触层,由于材料电阻率过高,甚至无法测得其载流子密度与迁移率。相比之下,最低掺杂浓度的梯度接触层未出现迁移率退化,且在沟道凹槽刻蚀前后均保持了足够的面电荷密度。
)晶面倒易空间映射。两种结构中,梯度AlGaN层均与下方的AlN衬底保持共格应变,这通过Qz方向的峰位对齐及AlGaN衍射条纹未出现镶嵌展宽现象得以证实。原子力显微镜图像显示两种结构表面形貌光滑,均方根粗糙度较低,且可见清晰的台阶边缘。这些结果表明构成器件的外延材料具备优异的结晶质量。霍尔效应测量结果如表I所示。由于测量对象为组分梯度层,所获面载流子浓度与迁移率均为等效值(完整的多层霍尔分析超出本研究范畴)。仅含沟道的PolFET结构作为参照基准,展示了无附加接触层时的沟道本征特性。而重掺杂梯度接触层样品则表现出电子迁移率下降及载流子浓度低于预期的现象。对于掺杂浓度最高的梯度接触层,由于材料电阻率过高,甚至无法测得其载流子密度与迁移率。相比之下,最低掺杂浓度的梯度接触层未出现迁移率退化,且在沟道凹槽刻蚀前后均保持了足够的面电荷密度。

图2. 本文所述两种PolFET样品的材料表征结果。(a)和(b)分别为仅含沟道PolFET与含梯度接触层PolFET的( )晶面倒易空间映射图;(c)和(d)分别为原子力显微镜获得的上述两种样品的表面形貌图,显示二者均具有光滑的表面。
)晶面倒易空间映射图;(c)和(d)分别为原子力显微镜获得的上述两种样品的表面形貌图,显示二者均具有光滑的表面。
为对比仅含沟道样品与最低掺杂梯度接触样品的接入电阻特性,本研究进行了传输线法测试,并据此提取了相应梯度沟道的比接触电阻。图3(a)展示了刻蚀至沟道后的TLM测试数据。仅含沟道结构与梯度接触结构在Al₀.₇₅Ga₀.₂₅N材料中的接入电阻分别为5 Ω·mm与0.6 Ω·mm,这表明具有导电性的梯度接触层可将沟道接入电阻相比纯金属-半导体接触降低一个数量级。图3(b)同时展示了2号样品的电流-电压特性曲线,显示其在凹槽刻蚀后仍保持线性接触特性。该梯度接触的比接触电阻值对MBE生长的Al₀.₇₅Ga₀.₂₅N而言亦处于极低水平。图4汇总了已报道的高铝组分AlGaN比接触电阻数据,结果显示本研究获得的电阻值在高铝组分AlGaN的金属-半导体接触与组分梯度接触中均属于最低水平之列。得益于接入电阻的降低,与无梯度接触层的PolFET器件相比,采用200 nm栅长的器件其最大漏极电流从仅0.85 A/mm提升至超过1.1 A/mm。具有梯度接触层的器件在特征频率/最大振荡频率(fT/fmax)方面也从26/28 MHz提升至33/35 MHz。器件性能汇总参见表II。这些结果表明优化接触层导电性能至关重要,而其优化方向可能并不直接对应于掺杂浓度的简单提升。
表I. 四种样品的霍尔效应测量数据汇总


图3. (a)具有梯度接触层的PolFET在刻蚀至沟道层后的TLM法测试数据;(b)样品2在栅极凹槽刻蚀前后,于间距为2至8 μm(以1 μm为间隔递增)的TLM测试电极上测得的电流-电压特性曲线。
表II. 结构1与结构2的接触及器件特性
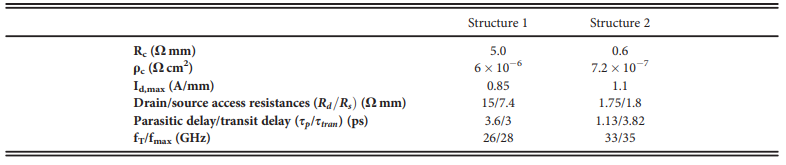
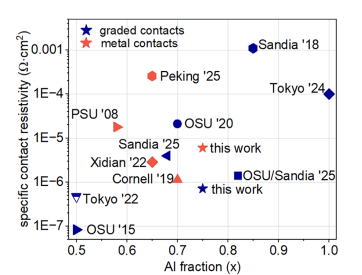
图4. 高铝组分AlGaN接触电阻性能对比,图中区分了纯金属-半导体接触(空心符号)、组分梯度接触(实心符号)及n+ GaN再生长接触(半实心符号)的测量结果。
在n型沟道上实现低电阻接触时,尽管已有研究证明通过在接触层中采用更高掺杂浓度可获得相对较低的接触电阻,但本研究发现更高的掺杂浓度并不总能对应形成足够导电的接触。多个研究组已报道,无论是MOCVD还是MBE生长的AlGaN材料,高浓度硅掺杂都会导致其电导率下降。关于此效应的解释包括DX中心与空位复合体的形成。先前研究已预测了高铝组分AlGaN中硅掺杂会形成DX中心,而空位复合体则在更广的铝组分范围内被观察到。我们认为,由于过量的正掺杂空间电荷无法完全抵消组分梯度产生的三维负极化电荷,这些因素的共同作用导致了最高硅掺杂层最终呈现绝缘特性。
从理论上讲,可以尝试通过增加接触层中组分渐变区域的厚度来降低克服三维空穴气所需的电荷面密度;然而,增加此类器件中AlGaN层的厚度可能引发多重负面影响。首先,这源于低铝组分AlGaN与底层AlN模板之间的面内晶格失配。高达2.4%的晶格失配会导致AlGaN层通过形成失配位错而发生塑性弛豫,进而增加穿透位错密度,最终降低器件中载流子的迁移率。此外,由于合金散射效应,AlGaN的热导率显著低于AlN或GaN。考虑到这类器件通常工作在大电流与快速开关条件下,更厚的AlGaN层会增加热阻,从而损害器件性能。
连续生长的梯度接触层相较于再生长接触技术具有显著优势:它消除了再生长界面杂质、组分突变,以及在刻蚀或掩膜表面上外延层成核质量不佳等问题所带来的复杂性。该技术确实需要对器件沟道进行精准可控的低损伤凹槽刻蚀,但本研究已通过刻蚀条件控制实现了这一工艺要求。仅含沟道的PolFET接触电阻与21世纪初的AlGaN/GaN基HEMT器件处于同一数量级,而梯度接触层的接触电阻虽然也在同一数量级,但仍比当前最先进的GaN基HEMT器件高出约六倍。通过去除沟道中的硅掺杂,梯度AlGaN晶体管可望获得进一步的性能提升。这不仅有助于提高沟道迁移率、缩短源漏间电子渡越时间,还能增强器件承受更高电场的能力,进而改善其击穿特性。
本文成功展示了面向Al₀.₇₅Ga₀.₂₅N材料的低电阻组分梯度接触技术,并阐明将接入电阻降低一个数量级可显著提升极化掺杂场效应晶体管的性能。该成果对于实现未来基于高铝组分AlGaN的射频功率放大器具有重要意义——因为较大的接触电阻会加剧开关时延并限制切换速度。本研究所报道的最低接触电阻,是目前通过任何生长方法在Al₀.₇₅Ga₀.₂₅N上实现的最低记录值,这为实现新一代高功率射频晶体管奠定了重要里程碑。
原文源于公众号【AIP Publishing】
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)