原文标题
Pulsed MOCVD promises to improve AlN-based power devices
原文刊登于英文杂志Power Electronics Magazine, Tuesday 12th August 2025
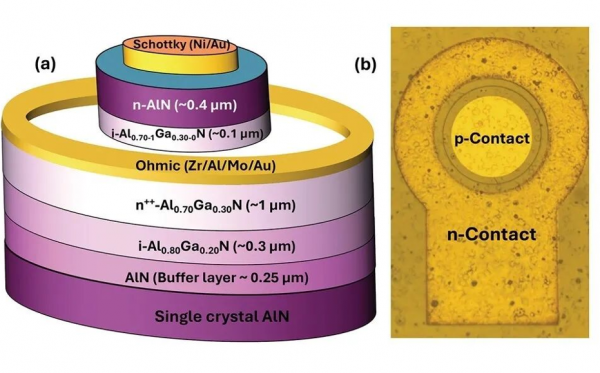
氮化铝基准垂直肖特基势垒二极管彰显脉冲MOCVD生长高质量n型材料的能力。南卡罗来纳大学的工程师通过使用该技术制造准垂直肖特基势垒二极管(a),展示了脉冲MOCVD用于AlN生长的强大能力;制造器件的顶视图(b)。
氮化铝(AlN)作为电力电子材料具有巨大潜力,其关键指标——巴利加优值(Baliga figure of merit)超过所有其他超宽禁带半导体。然而,器件性能受限于与掺杂相关的困难,包括高电离能以及自补偿缺陷的形成。
但根据南卡罗来纳大学的一个工程师团队的说法,从传统的生长方法转向脉冲MOCVD可以带来很大提升。这些研究人员声称,脉冲MOCVD能够实现更高效的AlN掺杂,同时降低电离能并提供更优异的掺杂控制。
由于AlN掺杂的困难众所周知,氮化物领域的研究人员已经研究了许多创新技术试图解决这个问题。这些努力包括使用在低温下进行的金属调制MBE,以减少自补偿缺陷的形成;以及在MOCVD过程中添加紫外光源,这种方法虽难以实施,但能实现费米能级控制并减轻自补偿。采用后一种技术,硅掺杂的AlN层可实现2x10¹⁸ cm⁻³的掺杂密度和160 cm²/V·s的迁移率。
南卡罗来纳大学的团队认为,他们的脉冲MOCVD比涉及紫外光源的技术更易于实施。今年早些时候,他们报道了从传统MOCVD转向脉冲MOCVD能使AlN的电导率提高一个数量级,现在他们正在展示这种生长技术在制造准垂直肖特基势垒二极管方面的能力。
为了制造这些功率二极管,该团队首先取用AlN衬底,采用传统MOCVD生长250 nm厚的未掺杂AlN缓冲层,随后是非故意掺杂的Al₀.₈Ga₀.₂N层,1 μm厚的硅掺杂Al₀.₇Ga₀.₃N层用于形成接触,以及100 nm厚的未掺杂渐变层,其中铝组分从70%增加到100%。
详细介绍这项工作的论文合著者Abdullah Al Mamum Mazumder告诉《化合物半导体》杂志,他们使用传统MOCVD来生长这些层,是因为它能够兼顾效率和高生长速率。
"对于掺杂AlN层的生长,使用脉冲MOCVD在可实现掺杂剂掺入和更小的施主电离能级方面提供了重要优势。这就是为什么在这项工作中我们仅使用脉冲MOCVD来生长有源AlN层。"
工程师们从他们的外延片上制造了具有圆形几何结构的准垂直肖特基势垒二极管。为了制造这些器件,他们使用标准光刻和电感耦合等离子体反应离子蚀刻来定义台面并触及Al₀.₇Ga₀.₃N层——在该层上他们使用电子束蒸发形成了n型接触。通过电子束蒸发添加肖特基接触。这完成了二极管的制造,其肖特基接触和欧姆接触之间有10 μm的间距。
电学测量显示,该团队的肖特基势垒二极管具有约395 V的击穿电压。根据模拟,峰值电场击穿强度为9.9 MV/cm。工程师们指出,结合钝化和场板技术可以使击穿时的电场接近AlN的临界电场(12-15 MV/cm)。
该团队的肖特基势垒二极管开启电压约为2.2 V,理想因子为2.4,这归因于AlN表面的氧化物形成以及金属-AlN界面不完美。"我们计划在未来的工作中解决这些问题,"团队成员Tariq Jamil说。
其他目标包括对高铝组分的AlN和AlGaN材料的脉冲MOCVD生长进行系统研究。
"我们的任务包括提高掺杂水平、优化材料质量、以及进行迁移率和电流输运分析与优化,"Mazumder说。"我们也在致力于利用脉冲MOCVD开发新器件。这些包括垂直和准垂直的肖特基二极管和p-n二极管,以及晶体管。"
参考文献
A. A. M. Mazumder et al. Appl. Phys. Express. 18 065501 (2025)
原文转载于【Power Electronics Magazine】官网
(以上文章由奥趋光电翻译,如有涉及版权等问题,请联系我们以便处理)